【集成电路】关键莱利公式扮演半导体制程微缩重要基础
半导体讲求制程微缩,生产的芯片除了有更小体积、更好效能之外,也有更优异的耗能表现。而在制程微缩的需求下,微影曝光设备能提供的效能就更加关键。如何让微影曝光设备能提供更加精密的工作效能,全球微影曝光设备大厂ASML就在官方Facebook公布关键公式:莱利公式(Rayleigh Criterion),使半导体微影曝光设备能持续发展。
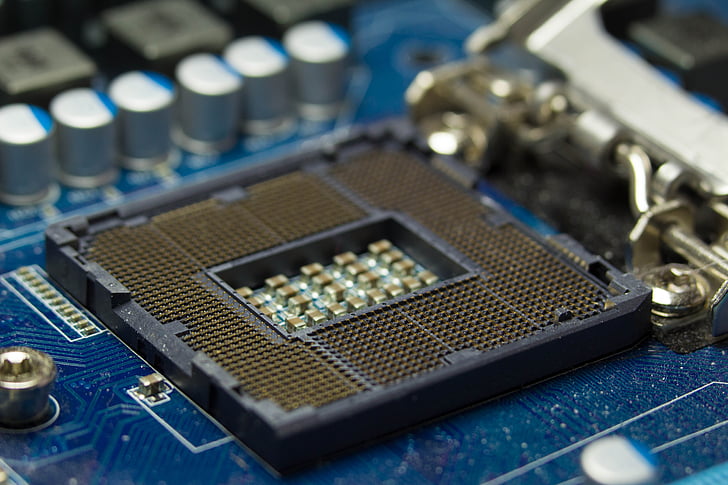
ASML指出,莱利公式为CD=k1 x(λ/NA),描述了重要参数间的对应关系,CD(Critical Dimension)中文译作关键尺寸或临界尺寸,而k1为变因,λ则是曝光机所用的光源波长,最后NA(Numerical Aperture)就是代表光学系统的数值孔径。
利用此公式,在半导体制程中,希望生产的芯片体积越来越小、搭载效能越来越高。也就是说,必须将公式中的λ(光源波长)缩小、NA(反射镜数值孔径)提高,让最后得到的CD越来越小。虽然有此公式辅助,但同时还是必须有曝光机的内部构造和工作模式的发展,这也是提升芯片生产效能和良率的关键要素。
ASML进一步表示,透过莱利公式持续改善我们的微影设备,并透过专业的微影技术、与客户及供应商的紧密合作,协助全球半导体产业提升制造良率和产能,实现芯片微缩蓝图,让终端消费者能够用更合理的价格买到功能更强、体积更小巧的电子产品,进一步提升人类的生活品质。


